时间:2020/01-07| 作者:admin
1 市场呼唤散热材料
物联网、云计算、大数据等正潜移默化地改变着人们的日常生活,无论何种技术在背后支持这些突破革新,都离不开系统底层的半导体器件。联网性、移动性以及不断增强的显示功能对电子产品系统集成度的要求越来越高,功率密度不断增加,尺寸逐渐缩小。此外产品的性能和运速要求也日益提高,而这一切都是建立在以半导体为基础的技术创新之上。
半导体芯片在不断提高集成度、功率密度和缩小尺寸的同时,也对系统散热技术提出了更严苛的要求,电子行业期待有一种既具有完美的散热性,又满足可靠性要求的散热材料“全能选手”为其保驾护航。
2 散热材料的基本要素
散热材料,亦称为导热界面材料(Thermal Interface Material,TIM),就关键热特性而言,TIM负责将芯片中的热量传导给散热片、同时填充气隙或界面上不平整的部分以更好地将热量散播到导热片中。如图1所示。
TIM的主要特性包括以下几点。
散热性能:热阻(TI)越低、热传导性能越好;
热稳定性/可靠性:热稳定性越高,出现故障的风险就越低,产品寿命就越长;
可压缩性:压缩性越好,热设计窗口和厚度范围就越宽,从而能够覆盖具有多个组件和堆叠管芯布板的高密度电路板中的各种气隙。
此外,在外形封装方面,使用起来越方便,导热垫片的效能就越高。
TIM种类主要包括相变材料(Phase Change Material,PCM)、硅脂、导热垫片和凝胶等,这些材料都具有不同的特性。
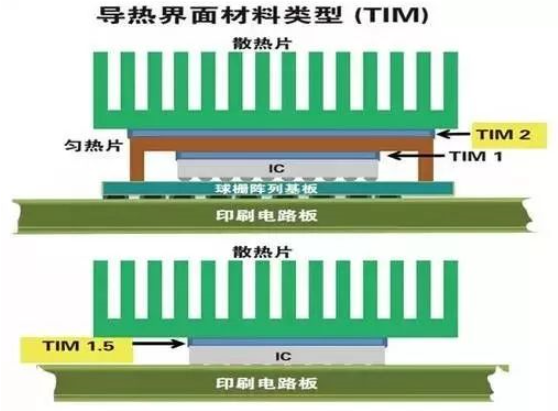
图1导热界面材料(TIM)各种类型和应用位置
2.1 TIM的选择
芯片功能越强大,对散热管理解决方案的要求就越高。除了要防止热积蓄,保持设备冷却以更好地工作外,还要确保其使用寿命更长。无论是大型独立设备(电脑、服务器甚至汽车产业)还是移动设备,都根据摩尔定律在进步,芯片越变越小,温度越聚越高。散热设计工程师不仅要关注热性能,还要处理热冲击下的稳定性,并防止出现挤出和变干的问题。
但是,要找到兼具散热性与可靠性的理想散热管理解决方案并非易事。过去,由于不同散热材料特性及其局限性,一直没有同时满足上述要求的普适性散热材料,电子产品厂商只能根据不同应用的散热要求,选择性地使用不同的散热材料。
高端、大功率应用要求有较长的产品质保和生命周期(一般是5~10年),如商业服务器、工作站、汽车电子(发动机控制单元)等。随着功率密度不断攀升,大部分高端CPU/APU功率需求为65~110W,高端GPU功率需求在250W以上。客户希望在相当长的时间内性能保持不变,避免停机进行质保维修。在这一领域最重要的是TIM材料的时间稳定性,因此一般选择相变材料(PCM)以及硅脂作为主要散热材料。
而另一些应用如笔记本电脑、视频图形阵列(VGA)等,要求在较短产品生命周期内有强劲的性能表现,其最初“开箱”阶段应具有优异的热性能和较低的热阻(TI),热稳定性则是其次要需求。相变材料(PCM)和硅脂在该领域也同样适用。
高密度器件封装需要具备可压缩特性以及较高的热性能,实际应用中包括智能电话和平板电脑等移动设备,这类应用涉及到堆叠管芯、多芯片封装、密度极高的电路板设计。间隙填充垫片或者热凝胶可以满足这类需求,但是相对于相变材料(PCM)和热硅脂,垫片和凝胶的散热性能有限。
2.2 硅脂与垫片/凝胶的应用局限性
硅脂由于其优秀的热性能成为应用最为广泛的TIM材料。硅脂因为其良好的流动性、较低的材料厚度(BLT),因此具有较高的热性能。但是,有机硅脂的长期可靠性一般不够理想,在重复热周期后,或者长期暴露在较高温度下会出现降解或性能下降等问题。因此不适合需要长期可靠性和耐用性的高端应用,其液体结构也使其不适合高密度器件封装。
间隙填充垫片是一种柔软的导热可压缩薄膜,一般由有机硅和陶瓷填充物构成。其具有各种各样的厚度、柔软度和导热特性,还可以交联和半固化,一般需要进行机械夹紧或者螺丝拧紧。
有机硅热凝胶也可交联或者半固化,材料厚度比间隙填充垫片更低,可以和热填充物一起装入。
间隙填充垫片与热凝胶两种材料的主要优点在于其压缩特性,但缺点是导热性能较差。
为简化操作,电子产品生产商一直在寻找通用性更好的TIM平台,既有优异的热性能又能保证长期可靠性,甚至还具有良好的可压缩性,以适用于各类应用。
2.3 PCM:突破局限性的全能选手
硅脂、间隙填充垫片和热凝胶的应用有限,而相变材料(PCM)技术由于配制的灵活性,突破了性能和成型特性的限制。思普瑞美科学家能够针对特殊应用重新组合各种特性,通过对PCM聚合物结构进行仔细的配制控制和处理,成功开发出新一代PCM材料,能够满足不同应用领域的需求。
PCM结合了导热垫片的可压缩性优点以及硅脂的热性能,同时又具有长期的可靠性。当温度达到其相变点或者融化温度时,PCM会从固态变成凝胶态。与硅脂相似,PCM的热阻较低、非固化,能够较好贴合,而且没有散开、干裂、 挤出等其他问题。这是基于其独特的聚合物结构和相变化学特性,以及专门为高性能器件开发的填充技术。
PCM一般以片状或膏状的形式提供,使用起来非常方便,可以将其直接封在离型膜中,切成各种厚度的垫片,更好地满足设计和散热要求。PCM的分子链要比硅脂长很多,长链结构实现了稳定而又连续的导热粒子散布与聚合物的一致性,提高了导热率,减小了聚合物因为压力、温度等问题导致的迁移。
大部分PCM含有蜡聚合物,这种材料当温度达到其相变点或者融化温度时,会从固态软化,或转换成凝胶态。融化的过程是可逆的,融化温度时一般在45℃左右。
温度越高,PCM黏性越低,可实现较高的浸润特性、较薄的材料厚度和较低的接触阻抗,提高了热阻。图2显示了PCM从固态到液态的转换,以及温度对黏性的影响。当温度降低后,PCM再次固化,保持聚合物基质的完整性,从而实现其长期可靠性。
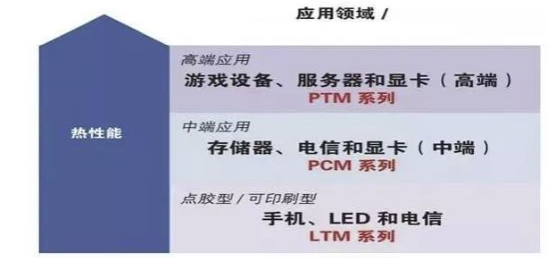
图2PCM从固态到液态的转换,以及温度对黏性的影响
3 思普瑞美先进的热管理解决方案
作为一家先进的材料供应商,思普瑞美电子材料部已经服务于半导体工业超过50年,持续为半导体和显示器行业提供关键材料。一直以来,该业务持续投资先进材料研发,并在TIM相变材料和低α粒子材料等方面取得突破性进展,可满足关键制造需求。
思普瑞美TIM属于相变材料(PCM),采用独有配方,并基于聚合物系统和先进填料技术实现。其可提供持久的化学和物理稳定性,具有热性能、热冲击稳定性、长期可靠性和低成本的优势,满足特定应用的需求。事实证明,相较其他容易干化或失效的替代导热界面材料,思普瑞美TIM材料可以长时间保持一贯的高性能表现,解决严苛的热管理问题,并提供在整个设备寿命周期内处于业内领先的可靠性。
思普瑞美TIM产品在加速寿命测试(ALT)中也表现优异。其独特配方可避免材料在极端工作温度和功率循环过程中出现挤出和降解,进而导致设备故障并缩短使用寿命的情况。思普瑞美TIM在高温老化过程中可提供一致的性能,其三大产品系列:PTM、PCM和LTM,分别面向高端、中端和可压缩性三种不同的市场应用需求,已在多类应用中作为热管理解决方案被广泛使用,能够有效地帮助电子设备解决内部半导体芯片的散热问题,确保设备性能的发挥以及可靠性。如图3所示。

图3思普瑞美TIM的三大产品系列满足各类市场的散热管理要求
思普瑞美TIM材料具有以下特点。
热阻小:热阻抗低至0.056cm2 ℃/W,可将热量更快地从芯片传递到散热片;
最佳的表面浸润性:减小接触热阻,提高热性能;
厚度更薄:解决组装问题,提高散热效果;
成本低:片状材料,可点胶版本,零浪费,无重大设备投入。
思普瑞美相变材料有片状式和可印刷式以供选择;还可提供其他多种封装材料,如散热器、电气相关材料、纯金属等。在工艺方面,思普瑞美TIM片状材料可提供一致的厚度和体积。在产品设计时就着眼于简化应用,不仅有助于用户最大程度地提高生产能力,还能获益于片状材料的精确性。可印刷式则有助于自动化生产及提高生产速度。如图4所示。